
掃碼添加微信�����,獲取更多濕法工藝資料
?
在半導體器件制造中,蝕刻是指選擇性地從襯底上的薄膜去除材料并通過這種去除在襯底上創(chuàng)建該材料的圖案的技術(shù)�����。該圖案由一個能夠抵抗蝕刻過程的掩模定義�,其創(chuàng)建過程在光刻中有詳細描述。一旦掩模就位�����,就可以通過濕化學或“干”物理方法蝕刻不受掩模保護的材料��。
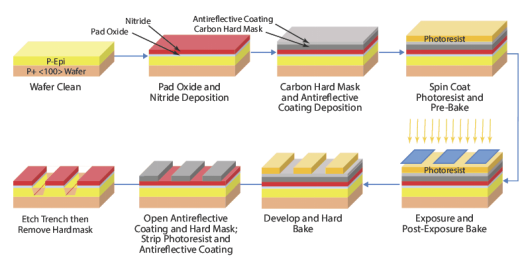
從歷史上看�,濕化學方法在用于圖案定義的蝕刻中發(fā)揮了重要作用,隨著器件特征尺寸的減小���,表面形貌變得更加關(guān)鍵���,濕化學蝕刻讓位于干蝕刻技術(shù)。這種轉(zhuǎn)變主要是由于濕蝕刻的各向同性��。濕法蝕刻會在所有方向產(chǎn)生材料去除����,如圖2所示��,這導致掩模定義的特征尺寸與基板上復制的特征尺寸之間存在差異�����。此外�����,先進設(shè)備中的縱橫比(深度與寬度之比)增加,實現(xiàn)這些比例需要使用定向蝕刻技術(shù)對材料進行各向異性蝕刻�����。圖3提供了一個示意圖����,有助于理解各向同性與各向異性特征生成和定向蝕刻。對濕法蝕刻在高級加工中的效用的最后打擊可能是這樣一個事實����,即許多用于器件制造的新材料沒有可用于蝕刻的濕法化學物質(zhì)。這些問題結(jié)合在一起使?jié)裎g刻技術(shù)幾乎只用于清潔而不是蝕刻應用�。只有特征尺寸相對較大的器件才繼續(xù)采用濕法蝕刻。表面清潔已在?各向異性特征生成和定向蝕刻�����。對濕法蝕刻在高級加工中的效用的最后打擊可能是這樣一個事實,即許多用于器件制造的新材料沒有可用于蝕刻的濕法化學物質(zhì)�����。這些問題結(jié)合在一起使?jié)裎g刻技術(shù)幾乎只用于清潔而不是蝕刻應用�����。只有特征尺寸相對較大的器才繼續(xù)采用濕法蝕刻���。表面清潔已在晶圓表面清潔

各向異性蝕刻使用了一系列被統(tǒng)稱為“干”蝕刻的技術(shù)�����。干蝕刻可以通過物理方式去除材料���,例如離子撞擊伴隨著材料從基板噴射或通過化學反應將基板材料轉(zhuǎn)化為可以被抽走的揮發(fā)性反應產(chǎn)物。干蝕刻技術(shù)包括以下常用方法(無論蝕刻過程是通過化學蝕刻���、物理蝕刻還是括號中所述的組合進行):各向同性徑向蝕刻(化學)��、反應離子蝕刻(化學/物理)���、濺射蝕刻(物理)���、離子銑削(物理)、離子束輔助蝕刻(物理)��、反應離子束蝕刻(化學/物理)��。所有干蝕刻技術(shù)都是在真空條件下進行的���,壓力在一定程度上決定了蝕刻現(xiàn)象的性質(zhì)����。
基本流程
在許多文本中可以找到對等離子蝕刻基礎(chǔ)的深入討論����,在這里�����,我們僅提供對等離子體生成基本原理的最簡要說明���。在等離子蝕刻工藝中����,有許多物理現(xiàn)象在起作用。當使用電極(在直流電勢或射頻激發(fā)的情況下)或波導(在微波的情況下)在等離子體室中產(chǎn)生強電場時����,該場會加速任何可用的自由電子,提高它們的內(nèi)能(那里在由宇宙射線等產(chǎn)生的任何環(huán)境中總是一些自由電子)�����。自由電子與氣相中的原子或分子碰撞���,如果電子在碰撞中將足夠的能量傳遞給原子/分子��,將發(fā)生電離事件�,產(chǎn)生一個正離子和另一個自由電子�����。然而�����,為電離傳遞的能量不足的碰撞可以傳遞足夠的能量以產(chǎn)生穩(wěn)定但具有反應性的中性物質(zhì)(即分子自由基)���。當給系統(tǒng)提供足夠的能量時���,會產(chǎn)生穩(wěn)定的氣相等離子體�����,其中包含自由電子�����、正離子和反應性中性離子����。
在等離子體蝕刻工藝中�,來自等離子體的原子和分子離子和/或反應性中性離子可用于通過物理或化學途徑或通過采用兩者的機制從襯底去除材料。純物理蝕刻(圖 4)是通過使用強電場將正原子離子(通常是重惰性元素如氬氣的離子)朝向基板加速來實現(xiàn)的�。這種加速將能量傳遞給離子�,當它們撞擊基板表面時,它們的內(nèi)部能量會轉(zhuǎn)移到基板中的原子上���。如果傳遞足夠的能量��,襯底原子將被噴射到氣相中��,然后被真空系統(tǒng)抽走�。入射離子在碰撞中被中和,因為它是氣體���,它解吸到氣相中��,重新電離或泵出系統(tǒng)����。?

? ? 化學蝕刻與物理蝕刻的不同之處在于����,它利用等離子體內(nèi)產(chǎn)生的反應性中性物質(zhì)與基板材料之間的化學反應。最常見的化學蝕刻類型涉及鹵化物化學���,其中氯或氟原子是蝕刻過程中的活性劑���。蝕刻工藝的代表性化學物質(zhì)是使用 NF3進行硅蝕刻。此蝕刻過程中的化學反應順序為:
NF?3?+ e?-?→???NF?2?+ F???+ e?-Si(s) +4F???→ SiF?4?↑
NF?3在等離子體中解離以產(chǎn)生高反應性原子氟自由基��。這些自由基與襯底中的硅反應生成四氟化硅 SiF?4���,這是一種可以被抽走的揮發(fā)性氣體�����。以這種方式從襯底蝕刻硅���?�;瘜W蝕刻與濕蝕刻一樣�,是一種沒有方向性的各向同性工藝(圖 5)���。其原因是反應性中性物質(zhì)的粘附系數(shù)相對較低�,因此與基材表面的大多數(shù)碰撞不會導致蝕刻���,而是使反應性中性物質(zhì)簡單解吸回氣相�����。這種現(xiàn)象導致被蝕刻的特征內(nèi)的蝕刻過程的平衡���,并最終導致蝕刻中的各向同性特征���。?

現(xiàn)代器件制造中使用的大多數(shù)蝕刻技術(shù)都結(jié)合了物理和化學蝕刻的各個方面���。在反應離子蝕刻等工藝中(RIE)��,定向蝕刻是通過偏置基板來實現(xiàn)的��,這樣等離子體中的離子物質(zhì)會朝著基板表面加速�����。在那里��,它們與表面和反應性中性物質(zhì)相互作用���,產(chǎn)生可以被抽走的揮發(fā)性產(chǎn)物(圖 6)。RIE 中的離子能量遠低于物理蝕刻技術(shù)所采用的離子能量�,并且離子轟擊效應可以忽略不計。離子能量轉(zhuǎn)移到表面可以通過改善反應物在轟擊表面上的吸附(進入的離子在吸附和反應優(yōu)先發(fā)生的地方產(chǎn)生高能量缺陷)和通過增強的副產(chǎn)物解吸(進入的離子能量轉(zhuǎn)移到反應產(chǎn)物導致它們從表面解吸)����。
注意:此處包含的信息、建議和意見僅供參考��,僅供您考慮�����,查詢和驗證,不以任何方式 保證任何材料在特定下的的適用性��。華林科納CSE對以任何形式�����、任何情況����,任可應用、測試或交流使用提供的數(shù)據(jù)不承擔任何法法律表任��,此處包含的所有內(nèi)容不得解釋為在任何專利下運營或侵如任何專利的許可或授權(quán)���。